Imishini Yokusika I-Laser Ye-Picosecond Enezinkundla Ezimbili Ye-Infrared Yokucubungula Ingilazi/I-Quartz/I-Sapphire
Ipharamitha eyinhloko
| Uhlobo lwe-Laser | I-Picosecond ye-Infrared |
| Usayizi Wepulatifomu | 700×1200 (mm) |
| 900×1400 (mm) | |
| Ukusika Ubukhulu | 0.03-80 (mm) |
| Isivinini Sokusika | 0-1000 (mm/s) |
| Ukuphuka Komphetho Okusikayo | <0.01 (mm) |
| Qaphela: Usayizi wepulatifomu ungenziwa ngezifiso. | |
Izici Eziyinhloko
1. Ubuchwepheshe be-Ultrafast Laser:
· Ama-pulse amafushane ezingeni le-Picosecond (10⁻¹²s) ahlanganiswe nobuchwepheshe bokuhlela be-MOPA afinyelela ubuningi bamandla obuphezulu >10¹² W/cm².
· Ubude be-infrared (1064nm) bungena ezintweni ezibonakalayo ngokumuncwa okungeyona i-linear, buvimbela ukubhujiswa kwendawo.
· Uhlelo lwe-optical olune-multi-focus oluyimfihlo lukhiqiza izindawo ezine zokucubungula ezizimele ngesikhathi esisodwa.
2. Uhlelo Lokuvumelanisa Lweziteshi Ezimbili:
· Izigaba ezimbili ze-motor eziqondile ezisekelwe ku-granite (ukunemba kokubeka: ± 1μm).
· Isikhathi sokushintsha isiteshi <0.8s, okuvumela ukusebenza "kokucubungula-ukulayisha/ukukhipha" okuhambisanayo.
· Ukulawulwa kwezinga lokushisa okuzimele (23±0.5°C) ngesiteshi ngasinye kuqinisekisa ukuzinza komshini isikhathi eside.
3. Ukulawulwa Kwenqubo Ehlakaniphile:
· Isizindalwazi sezinto ezihlanganisiwe (amapharamitha engilazi angaphezu kuka-200) sokufanisa amapharamitha okuzenzakalelayo.
· Ukuqapha i-plasma ngesikhathi sangempela kulungisa amandla e-laser ngokuguquguqukayo (isisombululo sokulungisa: 0.1mJ).
· Ukuvikelwa kwekhethini lomoya kunciphisa imifantu emincane enqenqemeni (<3μm).
Esimweni esivamile sokusetshenziswa esihilela ukuhlukaniswa kwe-sapphire wafer okuwugqinsi oluyi-0.5mm, uhlelo lufinyelela isivinini sokusika esingu-300mm/s ngosayizi wokuqhekeka ongaphansi kuka-10μm, okumelela ukuthuthukiswa kokusebenza kahle okuphindwe kahlanu kunezindlela zendabuko.
Izinzuzo Zokucubungula
1. Uhlelo lokusika nokuhlukanisa oluhlanganisiwe lweziteshi ezimbili ukuze lusebenze ngokuguquguquka;
2. Umshini wokulungisa amajiyometri ayinkimbinkimbi ngesivinini esikhulu uthuthukisa ukusebenza kahle kokuguqulwa kwenqubo;
3. Imiphetho yokusika engenamatheli enokunciphisa okuncane (<50μm) kanye nokuphathwa okuphephile komqhubi;
4. Ukushintshashintsha okungenamthungo phakathi kwemininingwane yomkhiqizo ngokusebenza okunembile;
5. Izindleko zokusebenza eziphansi, amazinga aphezulu okukhiqiza, inqubo engenazo izinto ezidliwayo kanye nenqubo engenazo ukungcola;
6. Akukho ukukhiqizwa kwe-slag, uketshezi olungcolile noma amanzi angcolile anobuqotho obuqinisekisiwe bomphezulu;
Isibonisi sesampula

Izicelo Ezijwayelekile
1. Ukukhiqiza Izinto Zogesi Zabathengi:
· Ukusikwa kwe-contour enembile yengilazi yesembozo se-smartphone ye-3D (ukunemba kwe-R-angle: ± 0.01mm).
· Ukubhoboza imigodi emincane kumalensi ewashi le-sapphire (ubuncane bokumboza: Ø0.3mm).
· Ukuqedwa kwezindawo zokudlulisa ingilazi ezibonakalayo zamakhamera angaphansi kwesibonisi.
2. Ukukhiqizwa Kwengxenye Yokukhanya:
· Umshini wokulungisa i-microstructure wama-AR/VR lens arrays (usayizi wesici ≥20μm).
· Ukusikwa okune-engela kwama-prism e-quartz kwama-laser collimators (ukubekezelelana kwe-engela: ±15").
· Ukuma kwephrofayili yezihlungi ze-infrared (ukusika okungaphansi kuka-0.5°).
3. Ukupakisha kwe-semiconductor:
· Ukucutshungulwa kwengilazi ngokusebenzisa (TGV) ezingeni le-wafer (isilinganiso sobukhulu 1:10).
· Ukuqopha iziteshi ezincane ezisekelweni zengilazi zama-chips amancane (Ra <0.1μm).
· Ukunciphisa ukuvama kwama-resonator e-quartz e-MEMS.
Ngokwenziwa kwamafasitela e-optical e-LiDAR yezimoto, uhlelo luvumela ukusika ingilazi ye-quartz engu-2mm ubukhulu ngokunqunywa okuqondile okungu-89.5±0.3°, okuhlangabezana nezidingo zokuhlolwa kokudlidliza kwebanga lezimoto.
Izicelo Zenqubo
Yenzelwe ngqo ukusika ngokunemba izinto ezibuthakathaka/eziqinile okuhlanganisa:
1. Izibuko zeglasi ezijwayelekile kanye nezikhanyayo (BK7, i-silica ehlanganisiwe);
2. Amakristalu e-Quartz kanye ne-substrates ye-sapphire;
3. Izihlungi zengilazi ezithambile kanye nezibonakalayo
4. Izisekelo zesibuko
Iyakwazi ukusika i-contour kanye nokubhoboza imigodi yangaphakathi ngokunemba (ubuncane obungu-Ø0.3mm)
Isimiso Sokusika Nge-Laser
I-laser ikhiqiza ama-pulse amafushane kakhulu anamandla aphezulu kakhulu asebenzisana nomsebenzi ngaphakathi kwezikhathi ze-femtosecond-to-picosecond. Ngesikhathi sokusabalala kwezinto, umsebe uphazamisa isakhiwo sawo sokucindezeleka ukuze wakhe izimbobo ze-filamentation zesikali se-micron. Isikhala semigodi esilungiselelwe kahle sikhiqiza imifantu emincane elawulwayo, ehlangana nobuchwepheshe bokuqhekeka ukuze kufezwe ukuhlukaniswa okunembile.
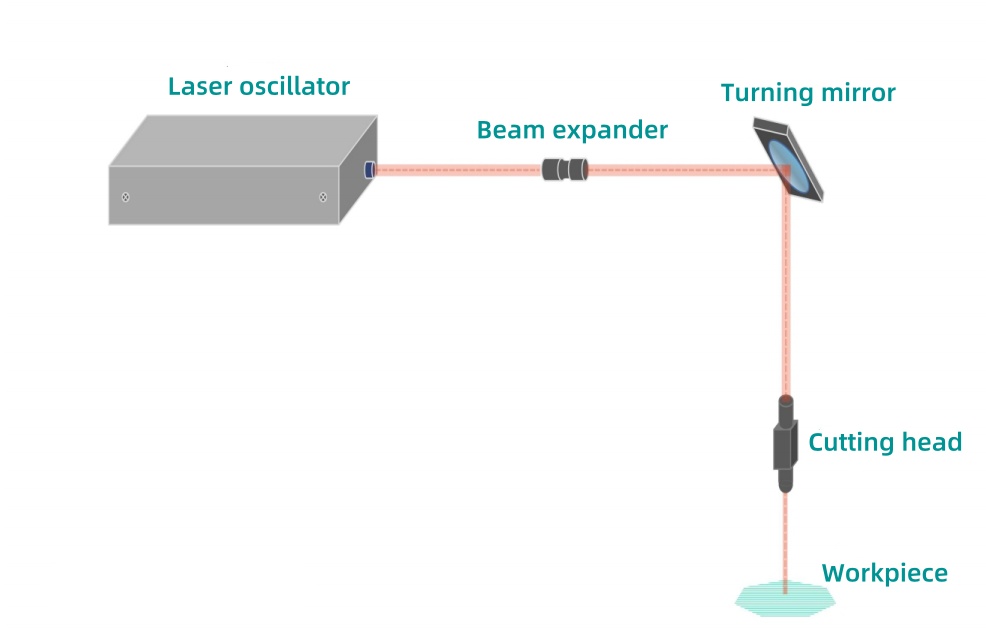
Izinzuzo Zokusika Nge-Laser
1. Ukuhlanganiswa okuphezulu kokuzenzakalela (ukusebenza okuhlanganisiwe kokusika/ukusika) ngokusetshenziswa kwamandla okuphansi kanye nokusebenza okulula;
2. Ukucubungula okungathintani kwenza amakhono ahlukile angatholakali ngezindlela ezivamile;
3. Ukusebenza ngaphandle kokusetshenziswa kunciphisa izindleko zokusebenza futhi kuthuthukisa ukusimama kwemvelo;
4. Ukunemba okuphezulu kakhulu nge-engeli engatheni kakhulu kanye nokususwa komonakalo wesibili we-workpiece;
I-XKH inikeza izinsizakalo eziphelele zokwenza ngokwezifiso zezinhlelo zethu zokusika nge-laser, okuhlanganisa ukucushwa kwepulatifomu eyenzelwe wena, ukuthuthukiswa kwamapharamitha enqubo akhethekile, kanye nezixazululo ezithile zesicelo ukuze kuhlangatshezwane nezidingo zokukhiqiza ezihlukile kuzo zonke izimboni ezahlukahlukene.




